您當前的位置:檢測資訊 > 科研開發
嘉峪檢測網 2025-03-27 08:38
二次離子質譜法(Secondary Ion Mass Spectrometry, SIMS)是一種通過向樣品表面照射高能離子束,分析由此產生的二次離子,從而實現元素定量分析和深度剖析的技術。離子轟擊下固體表面的二次離子發射提供了有關其最上面的原子層的元素、同位素和分子組成的信息。根據化學環境和濺射條件(離子、能量、角度),二次離子產生率會有很大的變化。這會增加該技術的量化方面的復雜性。
工作原理
在SIMS中,高能離子束照射樣品表面,引發濺射效應,從而產生二次離子。這些二次離子被質量分析器接收并分析,以實現元素的定性和定量分析。

離子生成機制
中性粒子:約占99%以上的濺射粒子,不帶電荷。
二次離子:帶電的濺射粒子,是SIMS的分析目標。
電子:由高能離子束激發,釋放到真空中的電子。
特點與優勢
廣譜適用性:幾乎適用于所有元素的分析。
高靈敏度:能夠檢測到微量元素(ppb至ppt級別)。
深度剖析能力:可進行樣品深度方向上的元素分布分析。
應用
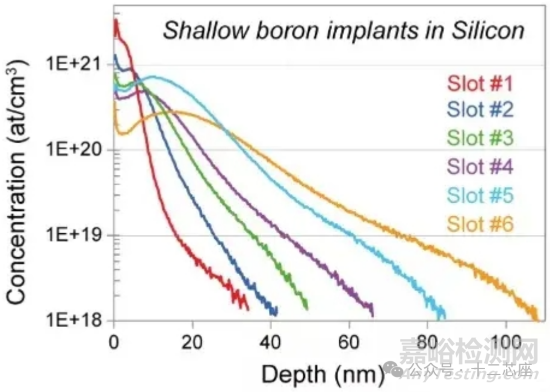
1. 異種材料界面位置的確定
在半導體材料中,例如AlGaAs/GaAs樣品,通過SIMS分析可以確定界面位置。
2. Si中的雜質濃度評估
通過SIMS對Si晶圓進行深度方向分析,可以評估雜質濃度。包括Si中的B, C, O和 N元素。
3. 淺注入和超薄膜的超高分辨率深度分析
結論
二次離子質譜法(SIMS)因其廣譜適用性、高靈敏度和深度剖析能力,在半導體領域應用廣泛。尤其在異種材料界面分析和雜質濃度評估方面具有重要價值,能夠檢測implant的注入深度,使其成為器件研發和仿真的關鍵手段。

來源:Internet


