您當(dāng)前的位置:檢測資訊 > 檢測案例
嘉峪檢測網(wǎng) 2025-04-13 11:11
芯片Test escape(測試逃逸)是指在測試階段未能有效攔截存在缺陷的芯片,導(dǎo)致其流入市場并引發(fā)故障。
Test escape常見的失效原因
1、測試程序或配置錯誤
測試文件或機臺參數(shù)設(shè)置錯誤(如BIN分類錯誤),導(dǎo)致不良品被誤判為良品。例如,某案例中晶圓廠因測試文件變更時編輯錯誤,將BIN11(不良品)歸入BIN1(良品)。
2、測試覆蓋率不足
未覆蓋關(guān)鍵功能或極端條件(如低溫、高溫、高壓等),導(dǎo)致潛在缺陷未被觸發(fā);或未覆蓋應(yīng)用場景,導(dǎo)致參數(shù)漂移樣品未被檢出。
典型案例分析
故障背景收集:
風(fēng)扇在整機生產(chǎn)測試測試中,在整機低溫測試時多臺風(fēng)扇不工作,常溫可恢復(fù)正常;進一步定位確認(rèn)為風(fēng)扇板上的霍爾芯片低溫不工作。
霍爾芯片具體分析過程:
1)芯片原廠初始分析結(jié)論:芯片EOS失效,懷疑為ESD導(dǎo)致;并通過故障復(fù)現(xiàn)回復(fù)說可以復(fù)現(xiàn)一樣的故障現(xiàn)象。

2)內(nèi)部實驗室分析:原廠分析的結(jié)果與整機故障表現(xiàn)不符,且內(nèi)部實驗室進行IV測試和開蓋均未見明顯的異常;同時,對單體進行bench測試,確認(rèn)在低溫時霍爾芯片參數(shù)會劣化;對霍爾芯片進行動態(tài)熱點定位,未發(fā)現(xiàn)明顯異常的熱點。
綜合上述的分析,推測失效根因——霍爾芯片test escape,參數(shù)臨界的霍爾芯片未測試攔截逃逸出來到終端客戶手上。
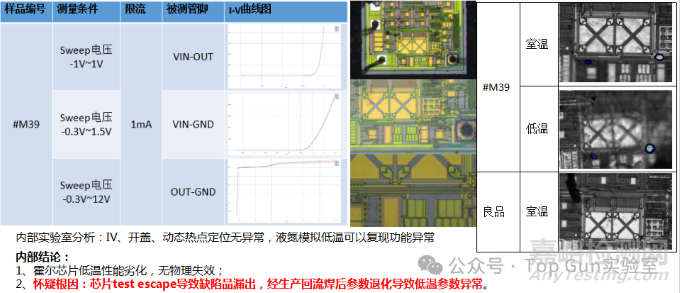
3)芯片原廠二次分析結(jié)論:故障芯片為test escape,根因為下發(fā)給晶圓廠的測試文件要求錯誤,導(dǎo)致某個不良的bin混入到良品。
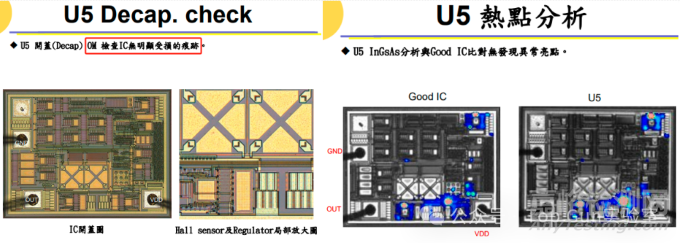
根因確認(rèn):CP測試機臺變更,下發(fā)變更單時編輯錯誤,BIN11的不良品被歸到BIN1的良品中。

調(diào)查生產(chǎn)記錄,從變更后BIN11數(shù)量為0,確認(rèn)根因。


來源:Internet


