近年來, 相控陣超聲檢測技術在各行各業的應用越來越廣泛�,相關檢測標準也陸續發布��,該檢測技術能夠以圖像方式顯示缺陷信息,能夠通過電子掃描等技術提高檢出率與檢測效率���。然而其也存在一定的局限性,例如由于聲束擴散�,不同聲程位置對應的聲束寬度不一致����,從而對缺陷的測量精度產生一定的影響���。
為了解決該問題����,超聲檢測領域開發了全聚焦檢測技術,近年相位相干成像(PCI)檢測技術也開始應用于工業檢測領域�����,其主要通過相位相干成像�,信號幅值對PCI成像沒有影響。因其在一些應用領域能夠對傳統相控陣技術和全聚焦技術進行有效補充�����,故應用范圍越來越廣泛����。
文章詳細介紹了全聚焦與PCI檢測技術的原理,從原理上分析二者的差異性����,并通過試驗測試PCI檢測技術對不同缺陷的檢測特點及效果�,了解PCI檢測技術針對不同類型缺陷的檢測優勢與不足���。
1�����、全聚焦成像檢測技術與PCI技術基本原理
全聚焦成像檢測技術是基于全矩陣數據采集的一種相控陣超聲后處理成像方法��。該技術能夠在設定的區域范圍內對每個位置都進行聚焦,使用時先設定聚焦區域�,并將聚焦區域按一定的分辨率劃分成網格����,再在網格交點位置進行聚焦�。
首先相控陣超聲儀器需進行全矩陣采集(Full matrix capture, FMC),全矩陣采集時首先激發第一個晶片���,然后其他所有晶片接收超聲信號;隨后激發第二個晶片�,然后其他所有晶片接收超聲信號���;依次以同樣的方式激發所有晶片�,得到各晶片相應的超聲信號�����,全矩陣采集完畢���。FMC激發及采集模式示意如圖1所示���。
圖1 FMC激發及采集模式示意
1��、全聚焦成像檢測技術基本原理
全矩陣采集完畢后,即可采用全聚焦數據處理算法���,對聚焦區域內所有預先定義的位置點進行聚焦算法處理�����,如圖2所示���。
圖2 全聚焦幅值計算示意
以圖2為例����,對聚焦區域的P點進行聚焦成像��,假設第i個發射晶片為Fi�,第j個接收晶片為Jj����,首先需要計算晶片Fi到成像點P的超聲傳播時間ti,同時計算成像點P到接收晶片Jj的傳播時間tj�����,得到超聲波從晶片Fi傳播至P點然后傳播至Jj晶片的傳播時間tij�����。假設在P點位置存在缺陷�,超聲波傳播至缺陷時反射至接收晶片Jj����,則Jj接收到的超聲信號在tij時間位置處會有較強的反射信號,將tij時間點對應的幅值Aij用于聚焦成像,P點成像對應的幅值為所有接收晶片接收到的超聲信號對應P點成像路徑幅值的疊加,假設有N個晶片��,則P點對應的全聚焦成像幅值可用下式表示:
(1)
全聚焦成像時�,需要通過式(1)計算得到所有聚焦區域內成像點對應的幅值,然后將疊加得到的幅值通過相應的顏色進行顯示。
2���、PCI檢測技術基本原理
PCI是基于全矩陣數據采集后的一種相控陣超聲成像處理算法�����。全矩陣數據采集相關原理與全聚焦成像檢測技術原理一樣���,只是數據采集后的數據處理成像算法不同�����。PCI成像主要利用超聲信號的相位信息進行成像�����,而不利用超聲信號的幅值信息進行成像,故超聲信號幅值不參與到PCI成像計算中����。
進行PCI成像��,首先需要將全矩陣采集到的A掃描信號相位化,A掃描信號的相位化示意如圖3所示,對應B點和D點位置的相位都是正相位����,A點和C點對應的相位為負相位��。通常正相位用1表示,負相位用-1表示�����,0點相位用0表示�����,因此經過相位化的A掃描信號每個時間點對應的相位值只會是1,0或-1三個值�����。采樣點的幅值為80%與10%對應的相位值都是一樣�����,均為1��,因此A掃描信號幅值對PCI成像影響很小,只要A掃描信號能夠準確得到相應點的相位信息即可�����。
圖3 A掃描信號相位化示意
PCI成像算法計算過程與全聚焦的計算過程類似��,需要將全矩陣采集到的A掃描數據通過符號函數相位化����。如果采樣點對應的A掃描信號幅值小于0即用-1表示���;采樣點對應的A掃描信號幅值如為0即用0表示�;采樣點對應的A掃描信號幅值大于0即用1表示。
PCI全聚焦幅值計算示意如圖4所示��,PCI成像需要得到P點的相位幅值信息����,假設第i個發射晶片為Fi,第j個接收晶片為Jj���,先要計算晶片Fi到成像點P的超聲傳播時間ti�����,同時計算成像點P到接收晶片Jj傳播時間tj�����,得到超聲波從晶片Fi傳播至P點然后傳播至Jj晶片的傳播時間tij,然后在接收晶片Jj接收到的A掃描信號中提取tij時間點對應的相位值фij�����。
圖4 PCI全聚焦幅值計算示意
P點對應位置的相位值為全矩陣采集數據中所有對應P點傳播路徑時間點相位值的疊加,如下式所示:
(2)
由PCI成像計算原理與過程可知,如果在成像點的對應位置��,各晶片接收到的A掃描信號相位不相干��,有可能負向疊加���,例如一些晶片采集數據對應的相位值是1����,一些晶片采集數據對應的相位值是-1���,進行疊加后抵消而變為0�����。全聚焦成像算法進行疊加計算時��,對應位置A掃描信號相位存在一些差異,其對應幅值也能正向疊加��,不可能出現負向疊加的情況�,這是PCI成像與全聚焦成像的最大區別。
2、PCI技術特點及檢測應用
PCI技術只使用相位值進行成像,具有自身的特點�,經過試驗測試驗證,某些特點有利于部分缺陷的檢測和測量�,某些特點不利于部分缺陷的檢測和測量�,下面重點介紹其對檢測應用的影響�。
1、PCI對反射信號弱的缺陷檢測信噪比高
PCI技術對一些反射能量較弱的缺陷信號有較高的信噪比�。
例如在相控陣檢測技術中經常用到衍射信號��,衍射反射信號傳播的角度范圍大,相控陣探頭各個晶片都能接收到衍射波信號�,但是衍射波信號能量很弱��,接收到的回波信號幅值很低,衍射波疊加后幅值還是較低��,很難與噪聲信號區分開�����,信噪比不高���。
由于PCI技術只使用相位進行成像���,各晶片接收到的衍射信號相位相干���,雖然衍射信號幅值低��,但通過相位值疊加后成像的信號較強,其顯示幅值與端角信號的幅值相當�����。
全聚焦技術與PCI技術檢測刻槽時的衍射信號成像顯示如圖5所示�����,其顯示的是深度為1���,2,3 mm刻槽的圖像�����,可以看到PCI技術顯示的刻槽衍射信號信噪比遠大于全聚焦檢測技術�����。通過全聚焦技術無法區分顯示深1 mm刻槽端點衍射信號與端角反射信號�����,而PCI技術能夠區分顯示深1 mm刻槽端點衍射信號與端角反射信號,提高了檢測分辨力����。
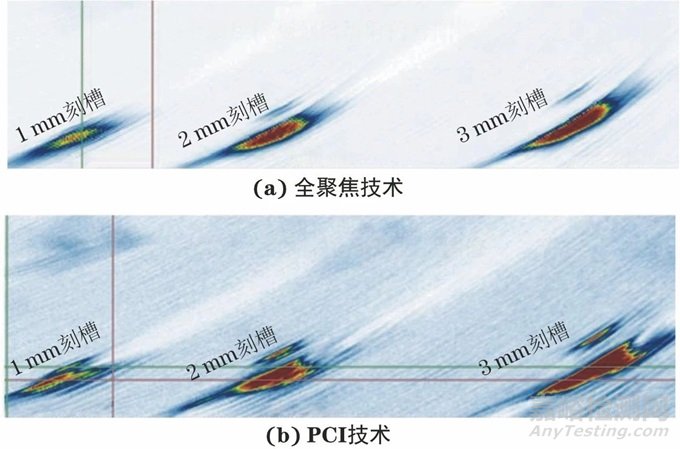
圖5 全聚焦與PCI技術的衍射信號成像顯示
由于幅值對PCI技術的影響小���,對于一些反射能量較低的較小缺陷����,PCI技術與傳統相控陣超聲及全聚焦技術相比有一定的優勢。
對一些晶粒較粗的材料����,缺陷信號幅值與噪聲信號幅值相差較小����,二者較難區分�。相控陣超聲探頭各晶片接收到的噪聲信號雖然幅值相差不大,但是其相位信息相差較大��,一些噪聲信號是正相位信號��,而一些噪聲信號是負相位信號,因此噪聲信號疊加時為非相干疊加����。而各晶片接收到的小缺陷信號通常為相干疊加�����,因此小缺陷信號的信噪比較高。
全聚焦技術與PCI技術分別檢測ф0.2 mm平底孔的檢測效果如圖6所示�����,可以明顯看出使用PCI技術得到的信噪比遠大于使用全聚焦技術����,并且PCI技術的上表面盲區也小于全聚焦技術的盲區。
圖6 全聚焦與PCI技術檢測ф0.2 mm平底孔的成像對比
2���、PCI對面狀反射體成像信號幅值弱
當相控陣探頭一個晶片激發產生的超聲波垂直入射至平面狀反射體時,激發晶片相鄰的晶片也能接收到較強的超聲信號���,但是各個晶片接收到平面反射超聲信號的相位存在一定差異,有些晶片對應位置點是正相位����,而有些晶片對應位置點是負相位�����,因此各晶片相位值進行疊加時,不是相干疊加,導致PCI技術得到的信號幅值弱��。
全聚焦與PCI技術檢測平面缺陷時的成像對比如圖7所示��,從圖中可以看到全聚焦成像能夠顯示很強的底面回波信號����、平面缺陷信號���、界面波信號���,而PCI成像圖中沒有顯示底面回波信號���、平面缺陷信號與界面波信號�����,因此檢測與超聲波入射方向垂直的面狀缺陷時,應盡量避免使用PCI技術。
圖7 全聚焦與PCI技術檢測平面缺陷的成像對比
經上述分析�,PCI技術對超聲波垂直入射至平面的反射成像信號弱�,從而能提高近表面缺陷的檢測分辨力���,全聚焦與PCI技術分別檢測近表面附近3個橫孔與下表面附近3個橫孔的結果對比如圖8所示��。圖8(a)為全聚焦檢測下表面附近橫孔的結果����,圖中能明顯區分橫孔信號與下表面回波信號。圖8(b)為PCI檢測下表面附近橫孔的結果,圖中可明顯看到橫孔信號,且沒有底面回波信號干擾,但信噪比比全聚焦圖像的差���。圖8(c)為全聚焦檢測上表面附近橫孔信號的結果,圖中可以看出一個橫孔信號與上表面信號重疊而無法識別,中間孔能看到����,但無法與上表面信號分開��。圖8(d)為PCI檢測上表面附近橫孔的結果,可以看出PCI檢測圖像沒有上表面信號干擾����,能在一定程度上減小上表面盲區,圖中能看到3個橫孔信號,但信噪比均不高��。
圖8 全聚焦與PCI技術檢測近表面缺陷的成像對比
3��、PCI技術對體積狀反射體成像能力與全聚焦相當
對于體積狀反射體����,各晶片接收到的相應位置反射信號在疊加時�,通過幅值疊加與相位疊加,都接近相干疊加,因此全聚焦成像效果與PCI成像效果相當,缺陷顯示均有較高信噪比�,全聚焦與PCI技術檢測體積狀反射體的成像對比如圖9所示����。
圖9 全聚焦與PCI技術檢測體積狀反射體的成像對比
3��、結語
PCI技術能夠提高點狀較弱反射缺陷的檢測能力����,例如裂紋尖端衍射信號���,同時能夠提高小缺陷檢測能力及粗晶材料工件的缺陷檢測信噪比�����。
PCI技術對平面狀缺陷檢測能力較弱�����,特別是對超聲波垂直入射至反射面的面狀缺陷,容易產生漏檢。
PCI技術能夠提高近表面缺陷的分辨力�����,減小近表面盲區��,對體積狀缺陷檢測能力與全聚焦技術的能力相當。
因此在使用PCI技術時�����,根據不同的檢測場景與檢測要求����,充分發揮其優勢,并可借助其他技術彌補其不足���。
作者:張瑞,鐘德煌��,王曉寧
工作單位:艾因蒂克科技(上海)有限公司
第一作者簡介:張瑞��,高級工程師�,主要從事工業及醫療超聲技術相關研究工作�。
來源:《無損檢測》2024年1期